실리콘 인터포저는 첨단 반도체 패키징 기술로 다양한 다이를 효과적으로 연결하는 역할을 하며, TSMC의 CoWoS를 개선한 에이직랜드의 차세대 패키징 기술에 대한 설명입니다. 이 기술은 성능, 전력, 비용 개선을 목표로 하며, CoWoS-S, CoWoS-R, CoWoS-L 등 다양한 패키징 형태로 제공됩니다. 실리콘 인터포저의 주요 용도와 기술에 대한 정보를 제공하고 있습니다.
목차
1. 실리콘 인터포저란 무엇인가?
1-1. 기본 원리와 구조
1-1-1. CoWoS 기술의 특징
1-1-2. 에이직랜드의 차세대 패키징 기술
1-2. 주요 용도
1-2-1. 실리콘 인터포저의 주요 활용 분야
1-2-2. 실리콘 인터포저의 활용 이유
1. 실리콘 인터포저란 무엇인가?

실리콘 인터포저는 반도체 패키징 기술의 한 부분으로, 다양한 반도체 다이(Die) 효과적으로 연결하는 역할을 합니다. 특히, 고성능 반도체에서는 로직 다이와 고대역폭 메모리(HBM) 등을 연결하는 데 사용됩니다. 이러한 인터포저 기술은 성능, 전력, 그리고 사이즈의 개선을 목표로 하며, 다양한 패키징 형태로 구현될 수 있습니다.
에이직랜드는 TSMC의 칩 온 웨이퍼 온 서브 스트레이트(CoWoS) 비용을 개선하기 위한 차세대 패키징을 개발 중입니다. 이 패키징은 재배선(RDL) 인터포저와 실리콘(Si) 브릿지, 그리고 히트 스프레더의 결합을 통해 이루어지고, 이를 통해 PPA(성능, 파워, 면적)의 개선이 가능합니다.
CoWoS는 파운드리 기업 TSMC의 어드밴스드 패키징 중 하나로, Si 인터포저와 TSV 등이 적용된 공정입니다. CoWoS는 크게 CoWoS-S(Si 인터포저), CoWoS-R(RDL인터포저), CoWoS-L(LSI+RDL인터포저)로 구분됩니다. 각각의 패키징은 다양한 특성과 장점을 가지며, 특정 어플리케이션에 따라 적합한 패키징 형태를 선택할 수 있습니다.
에이직랜드가 개발 중인 패키지는 RDL 인터포저를 활용하여 비용을 절감하고자 합니다. HBM, SoC 등은 RDL 인터포저 위에 배치되며, 다이 간의 연결은 실리콘 브릿지를 통해 이루어집니다. 또한, 발열을 줄이기 위해 히트 스프레더도 추가되었습니다. 이러한 패키징 기술은 향후 고객 확보에 긍정적인 영향을 미칠 것으로 예상됩니다.
1-1. 기본 원리와 구조
실리콘 인터포저는 반도체 패키징 기술의 한 부분으로, 다양한 반도체 다이 들을 연결하는 역할을 합니다. 이 기술은 로직 다이와 고대역폭 메모리(HBM) 등을 연결하는 데 사용되며, 특히 고성능 반도체에서 주목받고 있습니다. 엔비디아 A100, H100, 인텔 가우디와 같은 제품들이 실리콘 인터포저 기술을 통해 생산되었습니다.
1-1-1. CoWoS 기술의 특징
CoWoS는 Chip-on-Wafer-on-Substrate의 약자로, TSMC의 어드밴스드 패키징 기술 중 하나입니다. 이 기술은 Si 인터포저와 실리콘 관통 전극(TSV) 등을 활용한 공정을 포함합니다. CoWoS는 크게 CoWoS-S(Si 인터포저), CoWoS-R(RDL인터포저), CoWoS-L(LSI+RDL인터포저)로 구분됩니다.
- CoWoS-S
: Si 인터포저 위에 로직 다이와 HBM을 부착한 대표적인 CoWoS 패키지입니다. - CoWoS-R
: RDL 인터포저와 InFO를 적용한 형태로, CoWoS 대비 가격 경쟁력이 우수합니다. - CoWoS-L
: CoWoS-S와 InFO의 장점을 결합한 패키징으로, RDL인터포저를 통해 전체 비용을 축소하고, 로컬실리콘 인터포저(LSI)를 탑재하여 각 SoC와 HBM 간의 연결을 지원합니다.
1-1-2. 에이직랜드의 차세대 패키징 기술
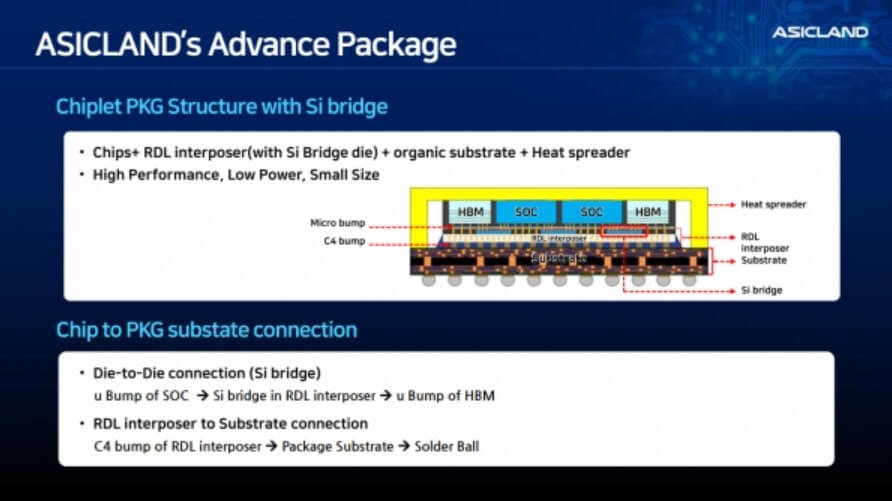
에이직랜드는 TSMC의 CoWoS 비용을 개선한 차세대 패키징을 개발 중입니다. 이를 통해 성능, 파워, 사이즈의 개선이 가능하다는 점을 강조하고 있습니다. 특히, 재배선(RDL) 인터포저와 실리콘(Si) 브릿지, 히트 스프레더의 결합을 통해 이러한 개선을 추구하고 있습니다.
에이직랜드는 현재 국내에서 유일한 TSMC 디자인하우스로, 지속적인 성장을 이루고 있습니다. 이러한 기술 개발은 향후 고객 확보와 시장 경쟁력 강화에 큰 도움이 될 것으로 예상됩니다.
1-2. 주요 용도
1-2-1. 실리콘 인터포저의 주요 활용 분야
실리콘 인터포저는 반도체 패키징 기술에서 핵심적인 역할을 합니다. 특히, TSMC의 칩 온 웨이퍼 온 서브 스트레이트(CoWoS)와 같은 첨단 패키징에서는 실리콘 인터포저의 중요성이 더욱 부각됩니다. CoWoS는 통합팬아웃(InFO), 오가닉 서브 스트레이트 패키지와 비교하여 성능과 전력 개선이 가능하며, 인터포저 사이즈를 자유롭게 조정할 수 있는 장점이 있습니다.
1-2-2. 실리콘 인터포저의 활용 이유
- 성능 향상
: 실리콘 인터포저를 활용한 패키징은 다양한 반도체 다이와 고대역폭 메모리(HBM)를 효과적으로 연결할 수 있습니다. 이에 따라 전체 시스템의 성능이 향상됩니다. - 비용 절감
: 에이직랜드는 RDL 인터포저를 활용하여 비용을 절감하고 있습니다. 실리콘 브릿지를 통한 다이 간의 인터커넥션과 히트 스프레더의 결합으로 성능과 전력의 개선이 가능하게 되었습니다. - 다양한 패키징 선택
: CoWoS는 다양한 형태로 제공되며, 각각의 패키징은 특정한 용도와 요구 사항에 맞춰 설계되었습니다. 예를 들어, CoWoS-S는 Si 인터포저 위에 로직 다이와 HBM을 부착한 형태로, CoWoS-R은 RDL 인터포저와 InFO를 결합한 형태로 제공됩니다.
반도체 패키지 관련 이전 게시글
TSV이란? - Through Silicon Via 기본 개념, 작동 원리, 장점, 제조 과정, 20203년 기술 동향
TSV(Through-Silicon Via) 기술은 반도체 분야에서 큰 혁신을 가져왔습니다! 이번 포스팅을 통해 TSV 기술의 기본 개념, 작동 원리, 장점, 제조 과정, 그리고 다양한 응용분야에 대해 알아보세요. 또한, 20
hongya-world.tistory.com
'IT & 과학 > 반도체 기술 공정' 카테고리의 다른 글
| 반도체 CFET 기술의 이해 : TSMC의 3D 트랜지스터 전략 // CMOS와 GAA (3) | 2023.09.18 |
|---|---|
| 에이직랜드의 2023년 차세대 패키지 - RDL 인터포저, 실리콘 브릿지, 히트 스프레더 // 첨단 반도체 패키징 기술(2/3) (0) | 2023.09.03 |
| 3D IC 설계 - TSV // IC 설계의 주요 문제점 & 향후 기술 전망 (0) | 2023.08.30 |
| TSV이란? - Through Silicon Via 기본 개념, 작동 원리, 장점, 제조 과정, 20203년 기술 동향 (0) | 2023.08.30 |
| NPU란? - NPU 기술의 개요, 구조와 역할, 딥러닝과의 관련성, 활용 분야(2023 New ver.) (1) | 2023.08.26 |



